FTIR-Spektroskopie zur Bestimmung der optischen Eigenschaften von Halbleitern
Exkurs:
IR-Ellipsometrie
Vortrag:
FTIR & IRSE
Spektroskopische Infrarot-Ellipsometrie
Die spektroskopische IR-Ellipsometrie (IRSE - Infrared spectroscopic ellipsometry) ist eine weitere Form der IR-Spektroskopie. Im Gegensatz zur Reflexion misst die Ellipsomtrie nicht die Änderung der Intensität, sondern die Änderung der Polarisation.
In der Regel wird unpolarisiertes Licht der Quelle linear polarisiert. Linear polarisiertes Licht lässt sich in zwei Komponenten zerlegen, parallel bzw. senkrecht zur Einfallsebene polarisiert. Bei Reflexion an der Probe werden beide Komponenten in der Regel unterschiedlich stark reflektiert. Außerdem erfahren beide Komponenten im Allgemeinen eine Phasenverschiebung relativ zueinander, sodass das Licht nach der Reflexion elliptisch polarisiert ist. Daher leitet sich auch der Name "Ellipsometrie" ab.
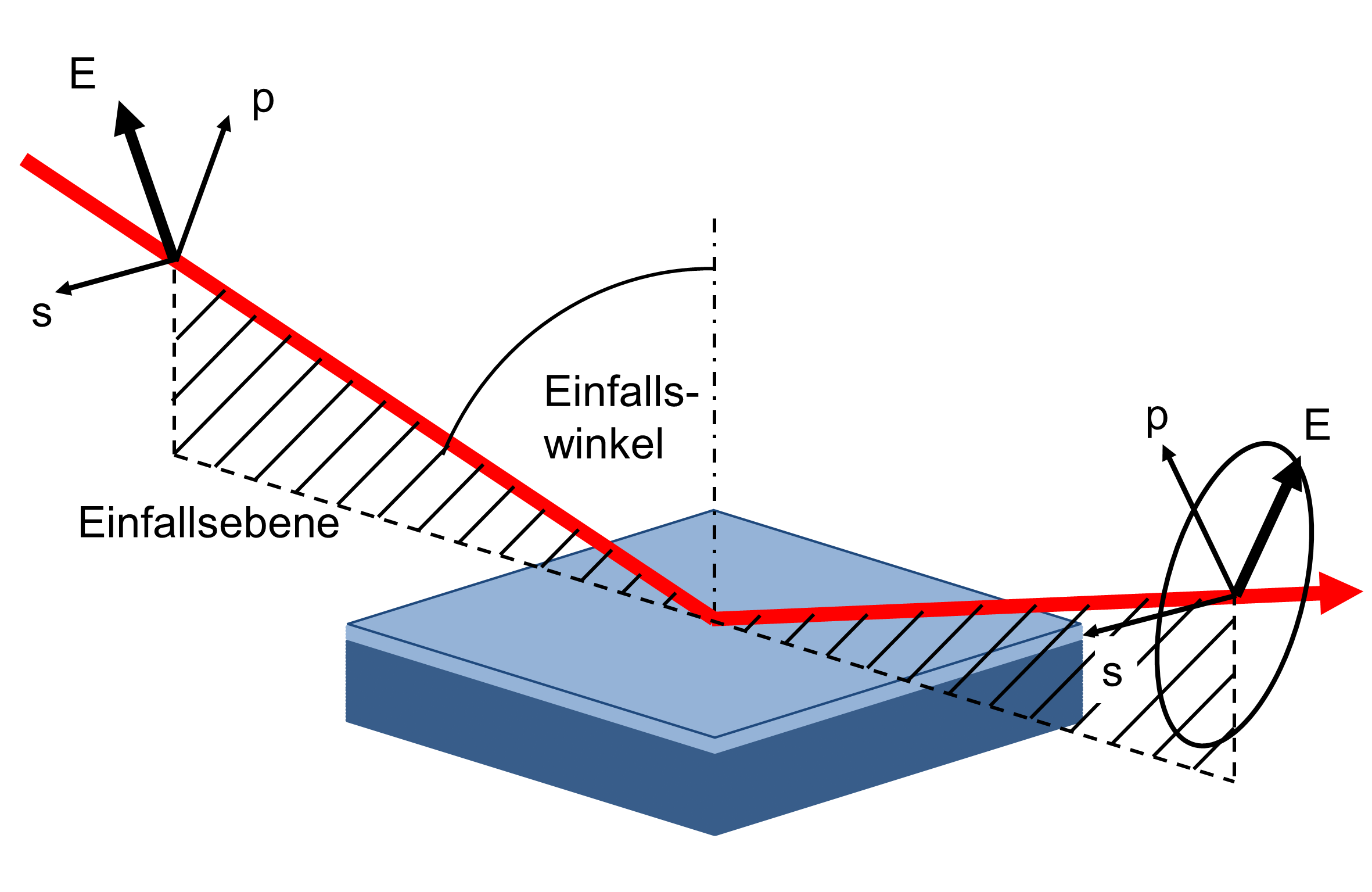
Abbildung 1: Schematische Beschreibung der Ellipsometrie.
Im einfachsten Fall (Probe ist isotrop, keine Depolarisation) kann die Änderung der Polarisation als das komplexe
Verhältnis der Reflexionskoeffizienten Rp zu Rs beschrieben werden:

Dabei beschreibt tan(Ψ) das absolute Verhältnis der beiden Reflexionskoeffizienten und Δ die Phasenverschiebung der beiden Komponenten.
Aus der obigen Gleichung lassen sich einige entscheidende Vorteile gegebenüber Reflexionsmessungen ableiten:
- Da ein Verhältnis bestimmt wird, ist die Ellipsometrie weitestgehend insensitiv gegenüber Intensitätsverlusten oder -schwankungen.
- Es werden immer (mindestens) zwei Parameter je Spektralpunkt gemessen.
- Es ist keine Hintergrundmessung notwendig.
- Es können sowohl der Real- als auch der Imaginärteil der komplexen dielektrischen Funktion oder des komplexen Brechungsindexes gleichzeitig bestimmt werden.
Die Infrarot-Ellipsomtrie hat seit Mitte der 1990er einen bemerkenswerten Aufstieg erfahren. Sie kann zur Charaktiesierung unterschiedlichster Materialien und Eigenschaften verwendet werden. Ein Auswahl folgt:
- Materialien: Halbleiter, Isolatoren, Metalle.
- Probenaufbau: Bulk, Einzelschichten, komplexe Heterostrukturen, Nanostrukturen.
- Eigenschaften: Gitterschwingungen, freie Ladungsträgerparameter.
- Optische Strukturen: Isotrop, uniaxial, biaxial.
Literatur
| [1] |
A. Röseler;
Infrared Spectroscopic Ellipsometry;
Akademie-Verlag, Berlin, 1990 ISBN 978-3055006234 |
| [2] |
M. Schubert;
Infrared Ellipsometry on Semiconductor Layer Structures: Phonons, Plasmons and Polaritons;
Springer Tracts in Modern Physics, Vol. 209, Springer, Heidelberg, 2004. ISBN 978-3-540-23249-0 |
| [3] |
H. Tompkins und E. A. Irene;
Handbook of Ellipsometry (Materials Science and Process Technology);
William Andrew Publishing, 2006. ISBN: 978-0815514992 |
| [4] |
H. Fijiwara;
Spectroscopic Ellipsometry: Principles and Applications;
John Wiley and Sons Ltd, 2007. ISBN 978-0470016084 |
| [5] |
A. Kasic;
Phonons, free-carrier properties, and electronic interband transitions
of binary, ternary, and quaternary group-III nitride layers
measured by spectroscopic ellipsometry;
Dissertation, Leipzig, 2003. Shaker, ISBN: 978-3-8322-2079-2 |
| [6] |
G. Leibiger; AIII-BV-Mischkristallbildung mit Stickstoff und Bor;
Dissertation, Leipzig, 2004. Shaker, ISBN: 978-3-8322-2642-8 |
| [7] |
T. Hofmann;
Far-infrared spectroscopic ellipsometry on AIII-BV semiconductor heterostructures;
Dissertation, Leipzig, 2004. Shaker, ISBN: 978-3-8322-3891-9 |
| [8] |
C. Bundesmann;
Phonons and plasmons in ZnO-based alloy and doped ZnO thin films
studied by infrared spectroscopic ellipsometry and Raman scattering spectroscopy;
Dissertation, Leipzig, 2005. Shaker, ISBN: 978-3-8322-4730-0 |

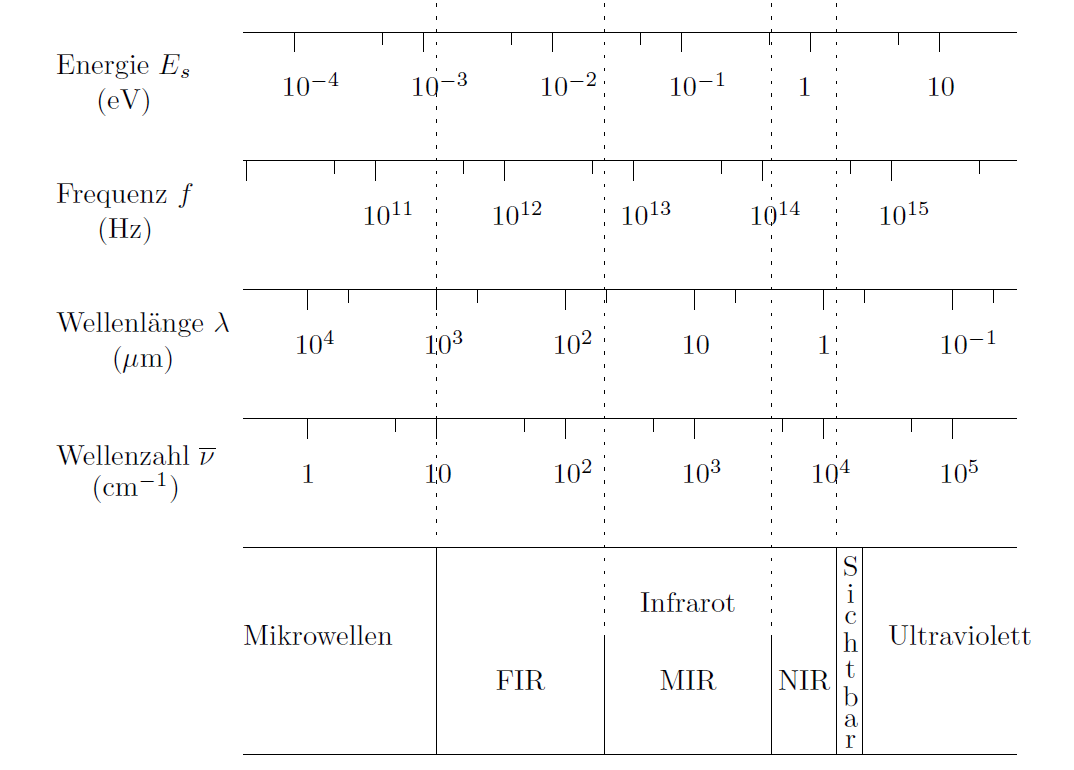

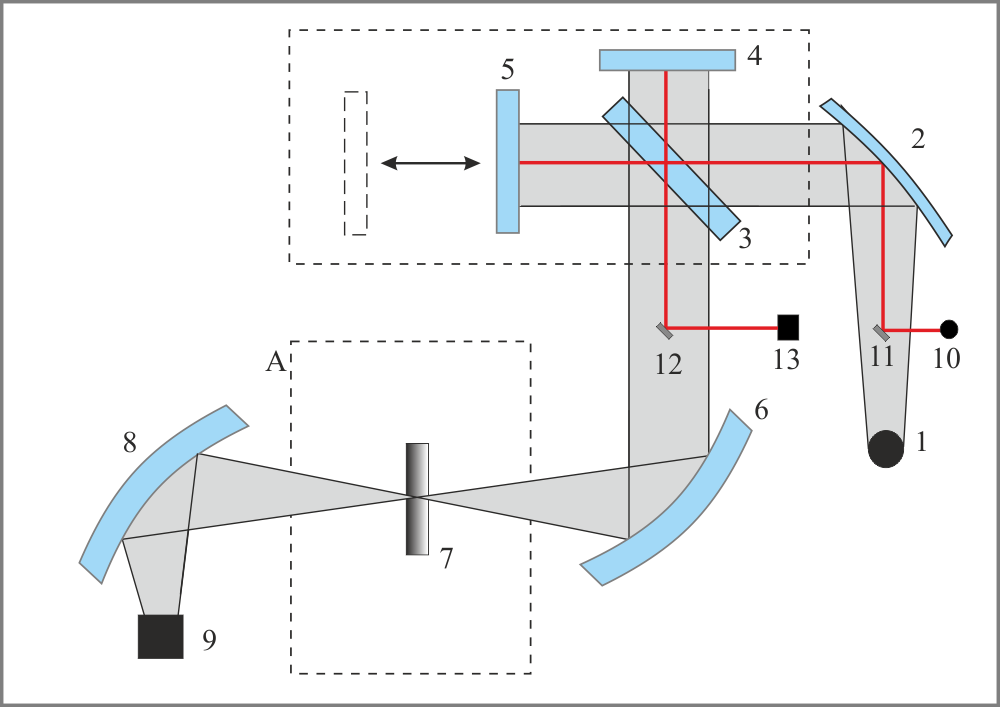
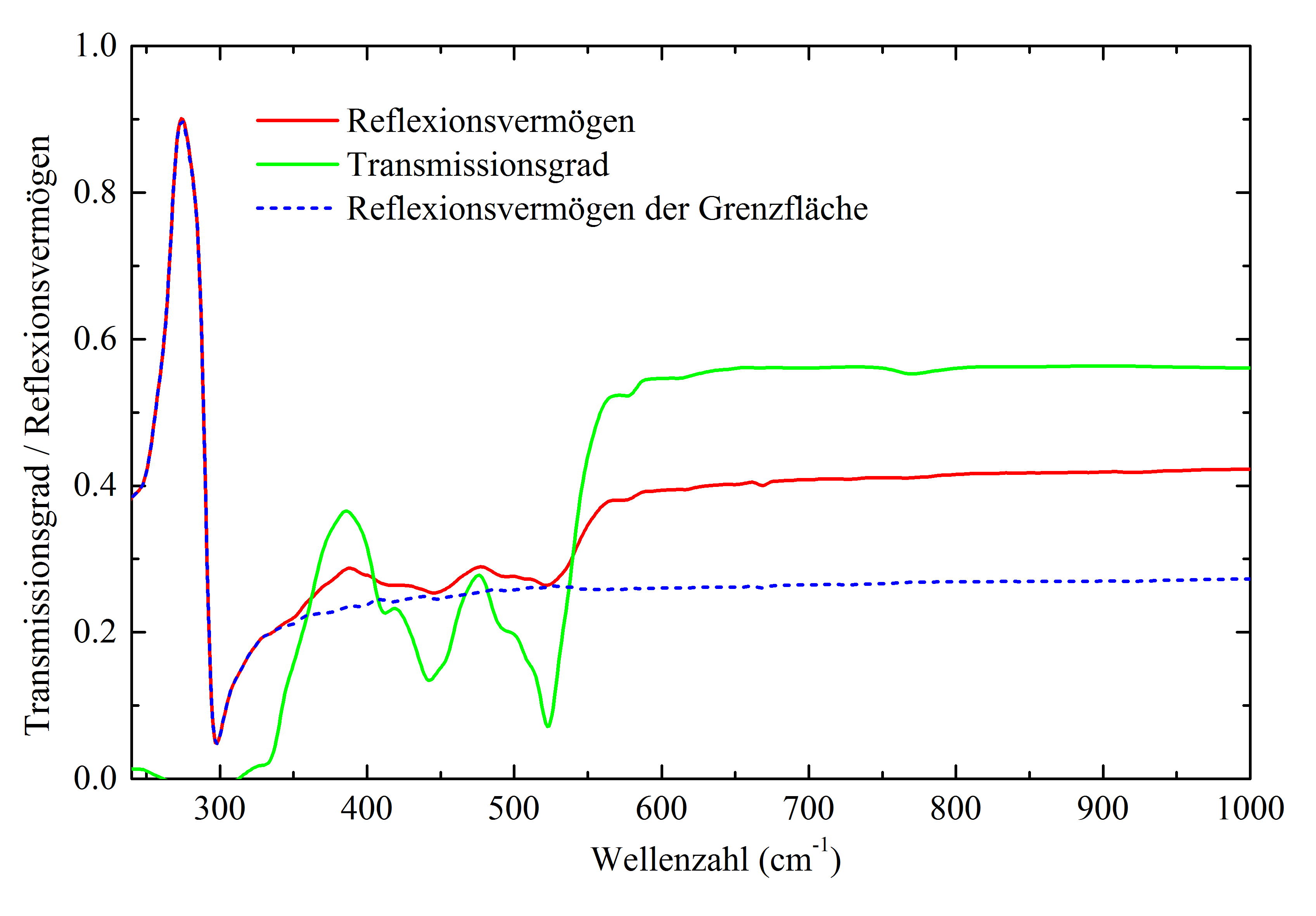
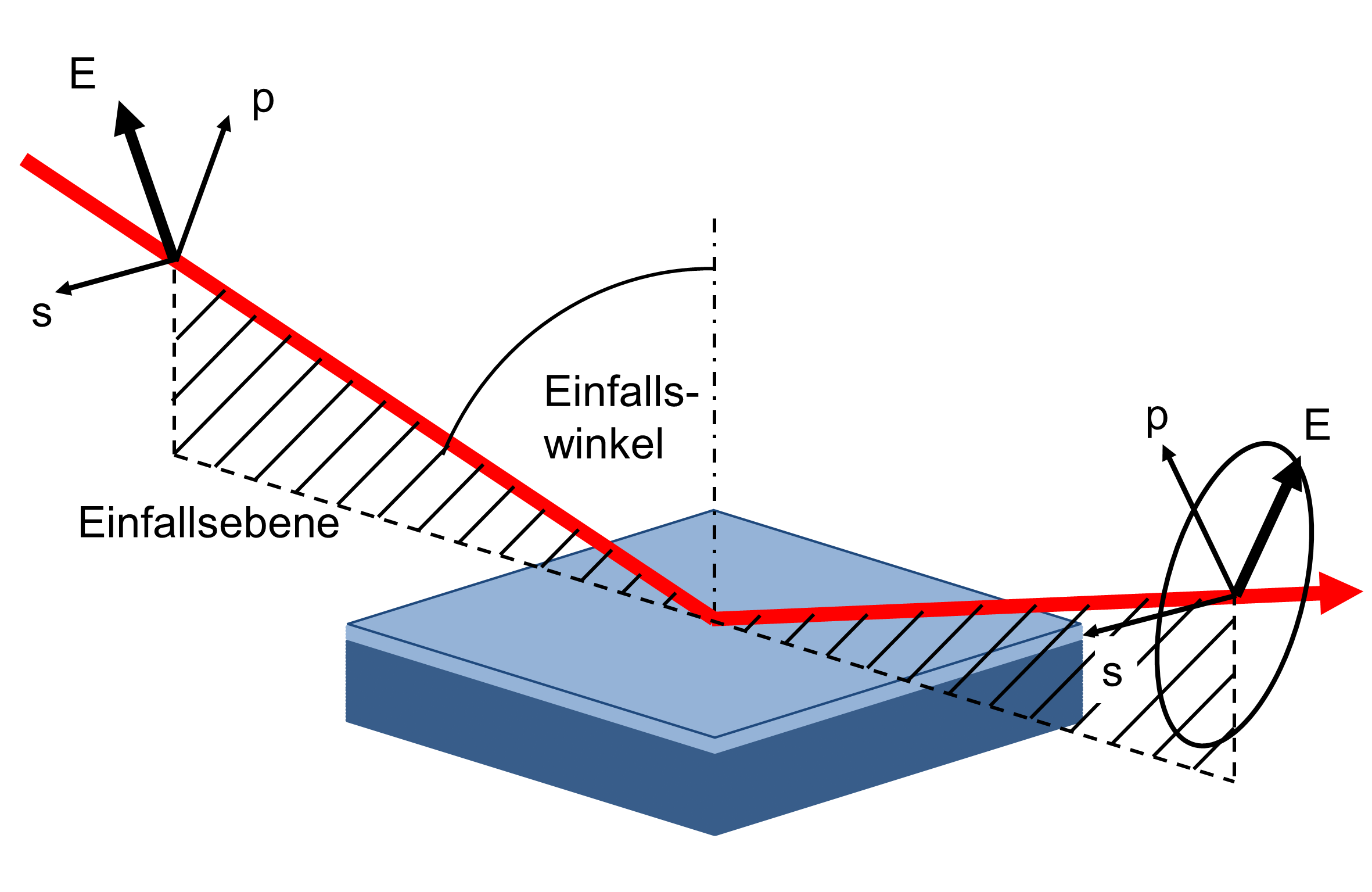

| Carsten Bundesmann, 2001 & 2014 | [Zurück zum Seitenanfang] | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||